|
���ڣ�ȫ��댧(d��o)�w�@ʾ�a(ch��n)�I(y��)�����(j��ng)�vһ����“�ɱ���(c��)”�l(f��)��ď�����ʎ����2025���°������m(x��)��2026��һ���ȣ��@ʾ�(q��)��оƬ��DDIC���Ĺ���(y��ng)朗l——�������εľ��A���쵽�к���ķ��b�yԇ——ӭ���˺�Ҋ��“�r���՝q”���档
�c�����ɽK�����l(f��)�(q��)�ӵĝq�r����ͬ����݆�q�r�ĺ����(q��)��������ԭ���ϳɱ������c�����Ƴ̮a(ch��n)�ܵĽY(ji��)��(g��u)���e�䡣�����B�Ӿ��A�c�����P(gu��n)�I�h(hu��n)��(ji��)��DDIC��y�I(l��ng)�������R��ǰ��δ�еijɱ��������@�ɉ������������a(ch��n)�I(y��)�����(d��o)����ʹ���ι���(y��ng)���c���S�̲��ò�����ҕ���r���ԡ�
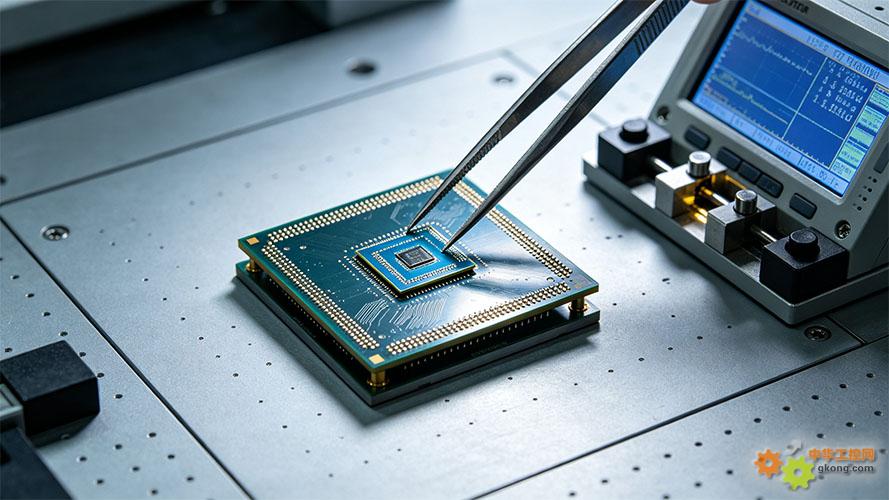
������(d��o)�����A���������Ƴ̵�“�ɱ�������”
Ҫ�����y�h(hu��n)��(ji��)�ĝq�r߉��������Ȍ�ҕ���ξ��A�����˵�“ˮԴ”����DDIC�ijɱ��Y(ji��)��(g��u)�У����A����ռ��(j��)�˸��_�����߳ɵķ��~���@��ζ�����A�r����κ�С���ӣ������ں�˱������Ŵ�
��(d��ng)ǰ�����A�����˵ĝq�r����Դ�������M���Ƴ̣����Ǽ�����DDICه������ij����Ƴ̡��e��8Ӣ�羧�A�a(ch��n)�ܣ������^ȥʮ���ИI(y��)�U�a(ch��n)���ļ�����12Ӣ�����M�Ƴ̣�8Ӣ��a(ch��n)���L��ȱ���Y��Ͷ�룬�a(ch��n)�ܲ��H�]�����L���������O(sh��)�����f�����p�ġ��c��ͬ�r����܇��Ӻ��I(y��)��(y��ng)�õ��Դ����оƬ��PMIC�������ʷ��������� aggressively ��ռ��������8Ӣ��a(ch��n)�ܡ�
�����P(gu��n)�I���ǣ�DDIC���a(ch��n)����ĸ߉��Ƴ�Ҳ�ܵ����ŔD�����ڲ��ִ����S�{(di��o)���ˮa(ch��n)Ʒ�����֣��p���˸߉��Ƴ̵Įa(ch��n)�ܷ��䣬��(d��o)��ԭ���;o���Ĺ����P(gu��n)ϵѩ�ϼ�˪����12Ӣ������Ƴ̷��棬�S�����ִ����S�s�p�߉��Ƴ̣�����DDIC�O(sh��)Ӌ�S�̱��ȼ������ٔ�(sh��)�Ա��������߉��Ƴ̮a(ch��n)�ܵĴ����S����ͶƬ����(d��o)���@Щ�S�̵Įa(ch��n)���������L�ھS���ڝM�d���c���h�r��(qu��n)Ҳ������������ڴ����S���С�
���⣬ԭ���ϡ���Դ�������ɱ��ij��m(x��)������ʹ�þ��A�����S����Ը���������ճɱ�������ͨ�^��r�����������f���@�N�������ε�“����”����ʹDDIC�O(sh��)Ӌ�S�̲��ò��_ʼ�c���͑���ͨ���u�����{(di��o)оƬ��r�Ŀ����ԡ�
��y���ĭh(hu��n)��(ji��)�������c��ˇ��“�p�ؔD��”
����DDIC���a(ch��n)�����г��φ��µ��P(gu��n)�I��(ji��)�c�����b�c�yԇ�h(hu��n)��(ji��)�ڱ�݆�q�r����̎��“���u����”����ɱ���(g��u)����Ҫ�ܵ��ɹ������ď����D����
1. �F���كr���j�����l(f��)�IJ��ϳɱ��ؘ�(g��u)
�@�DZ�݆��y�q�r����ĵ��T��DDIC�ں�������ЏV�����ý��K��Gold Bumping�� ��ˇ��ԓ��ˇ���S�������������2024���ԁ������H���r���m(x��)�߸ߣ��Ҵ�ͻ�ƚvʷ��λ��ֱ�ӌ�(d��o)���˽��K��ˇ�IJ��ϳɱ���ָ��(sh��)��������
�mȻ�����^����y�Sһֱ���аl(f��)�~懽��K����������Խ��͌��������ه�������g(sh��)�������һ�����͡���ȫ����������ռ�֮ǰ���S������ߌ�(d��o)��ԡ��߷�(w��n)���ԵIJ��ϣ���DDIC��y����Ȼ�y�Ա���ȫȡ������ˣ����r�į����ϝq�ɞ��˷�y�S��r���{(di��o)��ֱ�ӡ���Ե����ɡ�
2. �a(ch��n)�ܾoȱ�c�\�I�ɱ���“�����”�B��
�����F���٣���y�h(hu��n)��(ji��)߀���R�������o�σr�������_֧�Լ���Դ�����M�õ�ȫ���ϝq����������S���@ʾ���g(sh��)����߷ֱ��ʡ�����ˢ���ʰl(f��)չ�����(q��)��оƬ�ķ�y����Ҫ��Խ��Խ�ߣ��@�o���������˜yԇ�r�g��ˇ��(f��)�s�ȣ���������Ч�a(ch��n)�ܡ�
Ŀǰ���ض��ķ��b��������Լ�COF����Ĥ�������b����COG������оƬ���b�����ض��a(ch��n)���Įa(ch��n)��̎�ھoƽ���B(t��i)���ڮa(ch��n)�ܛ]�д�Ҏ(gu��)ģ�U���ı����£�һ������ԭ���ϝq�r����y�S���˾S�������ĠI�\�����ʺ���Ͷ�Y���������ɱ��D(zhu��n)�o�����DZ�Ȼ���̘I(y��)�x��(j��)�ИI(y��)��(sh��)��(j��)�@ʾ����y������r���������{(di��o)���E�����@һڅ�ݾ����^���ij��m(x��)�ԡ�
ȱ؛�cͨÛ���棺�a(ch��n)�I(y��)�δ����“�³��B(t��i)”
�˴�DDIC�a(ch��n)�I(y��)朵��������R�q����(bi��o)־���댧(d��o)�w�ИI(y��)�ڽ�(j��ng)�v��ǰ�����“ȱо”���M����һ��ȫ�µ�“ͨÛ����”��
����̎�ڮa(ch��n)�I(y��)����εķ�y�S���ԣ��������HҪ��(y��ng)���������ξ��A�������y�S�漰���������������ijɱ�������߀Ҫ��(y��ng)�������a(ch��n)�����ĵ��S�𡢻��W(xu��)Ʒ��׃�ӳɱ����mȻ��r�����ھ�����ڵ�ë�������������ͨ�^���g(sh��)�������烞(y��u)���K��ˇ����(d��o)���~��ˇ����ĸ����Ͻ��͌��F���ٵ���ه�������L�ڸ��������ڡ�
�������S�ͽK��Ʒ�ƶ��ԣ�DDIC�ĝq�r�o����ѩ�ϼ�˪���mȻĿǰ�K�����M����Ј������(f��)�K���^�в����ţ��@��һ���̶���������DDIC�O(sh��)Ӌ�S�̵���r���ȣ�ʹ��������̎�ڼ��ҵIJ����ڡ�Ȼ�����ɱ����۷eЧ��(y��ng)�Dz�����ġ�TrendForce�șC��(g��u)�Ĕ�(sh��)��(j��)�@ʾ�������A�����c��y�ɱ��q�����m(x��)�����O�����DDIC�q�r����ظ��ʡ�
�ɱ��(q��)�ӵĽY(ji��)��(g��u)������
�C��������DDIC��y���������εĝq�r����������𱬌�(d��o)�µ�“�u���Ј�”������һ�����͵ijɱ��Y(ji��)��(g��u)���Ƅ����顣��8Ӣ�羧�A�Įa(ch��n)�ܽY(ji��)��(g��u)�Ծoȱ�������H���r�j�������IJ��ϳɱ��؉���ÿһ���h(hu��n)��(ji��)�ĝq�r�����䲻�ɿ����Ŀ��^���ء�
���@���q�r���У������ИI(y��)��ƴ�IJ��كH�H��ӆ�Ϋ@ȡ���������ǹ���(y��ng)朵��g���c���g(sh��)������ٶȡ������ИI(y��)��(n��i)�T���Aо�������ԓ�I(l��ng)�����I(y��)���ԣ���݆�����������(zh��n)Ҳ�����C�����ڃ�(n��i)��Ҫ�挦�ɱ��E���ĉ������L�ځ������@Ҳ������ȫ�ИI(y��)���������Ч�����ͳɱ����¹�ˇ���g(sh��)�D(zhu��n)�͡����@һ���q�ݏص�ƽϢ֮ǰ��DDIC�a(ch��n)�I(y��)��ϵ�ÿһ�����c�߶���Ҫ�����L�ڑ�(y��ng)��“�߃r�r��”�Ĝ�(zh��n)�䡣
|